随着电子产品的多样化需求和发展,不仅要求产品体积越来越小,而且也要它的功能更加强大,特别是低功耗便携式产品。
而在电子产品中,电源是系统中体积比较大的部件,如果要将产品做小,就需要电源系统的功率密度要高,体积小,功率大。随之而来的问题是,空间变小了,内部产生的热量散发不出去,很容易导致电源系统损坏。而电源系统中的主开关器件是低电压功率MOSFET(金属-氧化物半导体效应晶体管),为了减小电源系统的体积及大功率输出,就需要解决改进MOSFET的封装散热性。
现有技术中的DFN(双面无引脚扁平封装)封装外形产品,因其引脚无外露,较其他封装外形产品,产品尺寸更小、封装厚度更薄等优势,越来越被业界广泛使用。
这种DFN封装外形产品双面散热的实现方法是:为芯片上贴铜片,铜片上再贴散热块,塑封成型。但是,这种方法因贴装的铜片为打弯工艺,铜片易出现贴装表面不平问题,回流焊接后容易倾斜变形,从而导致散热块表面不平、与塑封模具表面贴合不紧等问题,且易产生溢料,在实际的生产过程中需要增加去溢料和研磨等工艺,增加了操作的复杂。
为此,比亚迪在2019年8月23日申请了一项名为“芯片封装结构及电子产品”的发明专利(申请号:201910786655.9),申请人为比亚迪半导体股份有限公司。
根据该专利目前公开的相关资料,让我们一起来看看这项芯片封装结构吧。
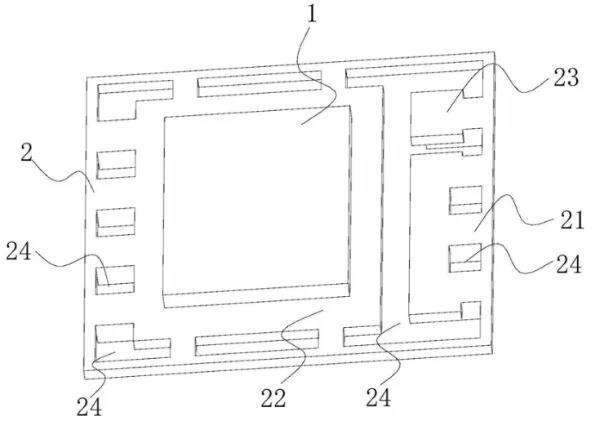
如上图,为该专利中发明的芯片封装结构中第一引线框架的结构示意图,该芯片封装结构由多个芯片封装单元组成,芯片封装单元之间通过框架连筋相连。当需要使用不同数量的芯片封装单元时,通过切割该框架连筋的方式来获得所需数量的芯片封装单元。
第一引线框架2上形成有功率引脚21以及承载平台22,芯片1的下表面可以采用焊接的方式固定在承载平台上,从而使芯片一部分热量经由第一引线框架的吸收并释放至外部,而功率引脚用于将芯片所处理的信号输出。
第二引线框架3固定于芯片的上表面从而使芯片的另一部分热量经由第二引线框架的吸收并释放至外部,从而达到良好的散热效果。并且,第二引线框架还可以与功率引脚相连,也即将芯片上表面的端口输出的信号经由第二引线框架传输给功率引脚,再通过功率引脚将信号向外输出。
这样的设计方案,能使第二引线框架与芯片的上表面以及第一引线框架上的功率引脚紧密贴合,保证第二引线框架的平整度高,避免出现倾斜。从而避免出现后续与塑封模具表面贴合不紧、产生溢料的问题,避免增加去溢料和研磨等工艺。
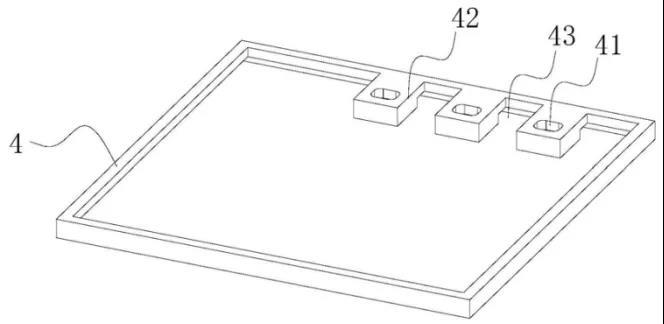
如上图,为芯片封装结构的第三引线框架的结构示意图,芯片封装单元还包括第三引线框架4,第三引线框架设置在第一引线框架和第二引线框架之间,且其上形成有多个间隔设置的连接引脚42,以连接功率引脚及第二引线框架。
在这种结构设计中,通过设置第三引线框架能够对第二引线框架起到有效的支撑作用,此外其上设置的多个连接引脚能够实现芯片上表面的信号端口与功率引脚之间的电气连接,从而将信号传输给功率引脚,再通过功率引脚将信号向外输出。

最后,是这种芯片封装结构的芯片封装单元的剖视图,可以看到,连接引脚上形成有第三半蚀刻凹槽,第三半蚀刻凹槽和第二半蚀刻凹槽相对设置,结合材100就设置在该两个相对的第二半蚀刻凹槽和第三半蚀刻凹槽内,从而可以进一步地增加结合材的量以更进一步地提高第二引线框架和第三引线框架之间连接的稳定性。
以上就是比亚迪发明的芯片封装结构,该方案在引线框架上设置有半蚀刻凹槽,在引线框架通过结合材与芯片以及功率引脚连接时,结合材可以保护于半蚀刻凹槽内而不溢出,以使引线框架与芯片的上表面以及引线框架上的功率引脚紧密贴合。该方案可以有效地保证较高的引线框架平整度,且避免了后续与塑封模具表面贴合不紧、产生溢料的问题。
|




